晶圆清洗机是半导体制造过程中重要的设备,其性能直接影响芯片良率、生产效率及产品可靠性。
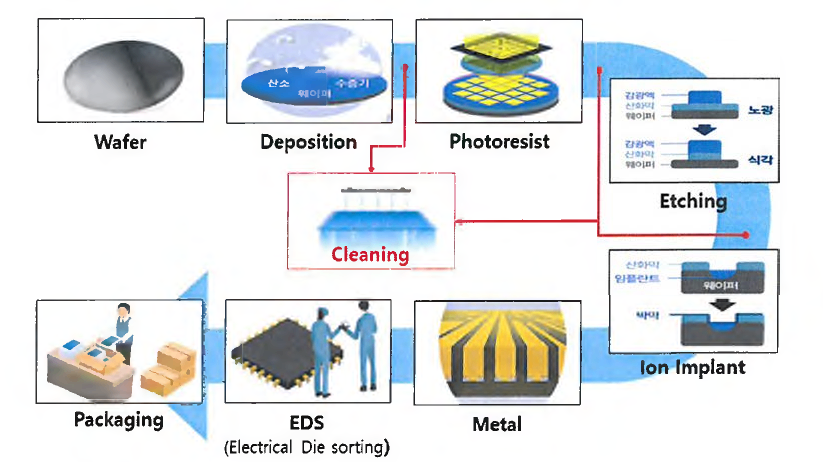
以下是其核心性能指标与技术特点的详细解析:
清洗效率与洁净度控制
颗粒去除能力:可有效清除≥0.1μm的微污染物
化学均匀性:通过动态分配系统确保各工位间清洗液浓度误差<±1%,避免因局部过蚀或清洗不足导致的缺陷。
干燥效果:配备旋转甩干+IPA蒸汽干燥模块,实现晶圆表面水渍残留量<10ppm,防止后续工艺中因水分引发的电迁移失效。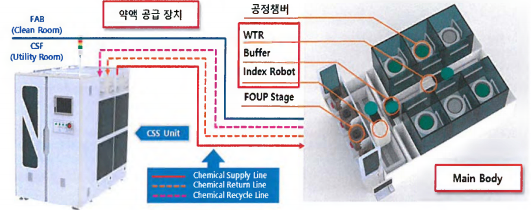
工艺适配性与柔性化设计
多流程兼容:8-12寸,机器人上下料,双EFEM-loadport装置,清洗和干燥装置等
非接触式传输与低损伤设计
伯努利吸盘系统:利用气压差实现晶圆悬浮传送,消除机械臂刮擦风险,尤其适用于超薄晶圆(厚度<700μm)和凸点倒装结构。配合边缘夹持装置,可有效抑制翘曲变形。
应力缓冲结构:在加热/冷却阶段采用梯度温控方案(升温速率≤5℃/min),避免热冲击导致的晶格缺陷。例如,在铜互连工艺后的低温清洗中,通过PID控制将温差控制在±1℃以内。









